“晶圆CMP机械化学平坦化” has been added to your cart.
View cart -

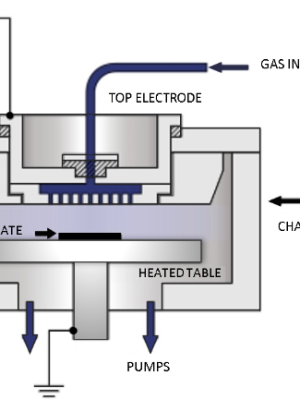
¥1,500.00
技术指标 晶圆尺寸: 6英寸 可沉积材料:SiO2、Si3N4、PSG等 片内均一性(1 sigma):≤1….
-

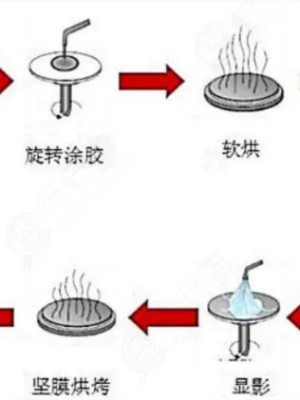
¥1,500.00
技术指标 涂胶工艺技术指标: 晶圆尺寸: 6英寸 匀胶片内均一性(1 sigma):≤1.5% 匀胶Wafer…
-

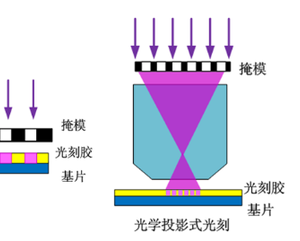
¥1,500.00
技术指标 晶圆尺寸: 2, 4, 6英寸晶圆及碎片光刻 分辨率: 1.5μm 正面套刻精度: ±0.5μm 照…
-

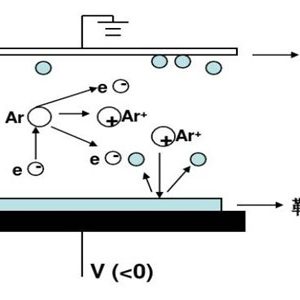
¥1,500.00
技术指标 晶圆尺寸: 6英寸 薄膜种类:掺钪氮化铝AlScN (Sc浓度20%) 片内均一性(1 sigma)…
-
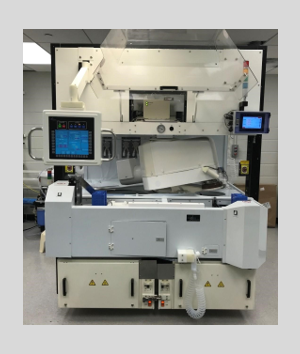
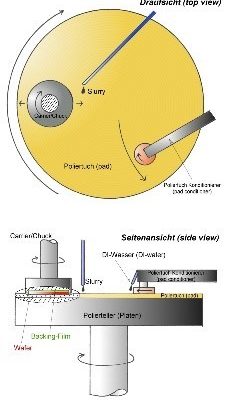
¥1,500.00
技术指标 晶圆尺寸: 6英寸 薄膜种类:SiO2、PSG 去除速率:2000A~3000A/min 均匀性:≤…
-

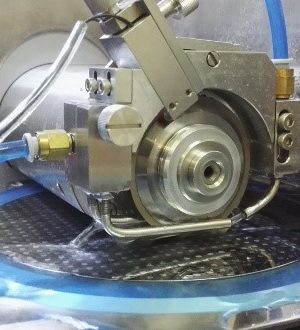
¥1,500.00
技术指标 晶圆尺寸: 2, 4, 6, 8英寸晶圆及碎片 晶圆厚度: 0.1-1.5mm 定位精度:3um Z…
-


¥1,500.00
技术指标 晶圆尺寸: 2, 4, 6, 8英寸晶圆及碎片 Wire Size: 20.3 um ( 0.8 m…
-

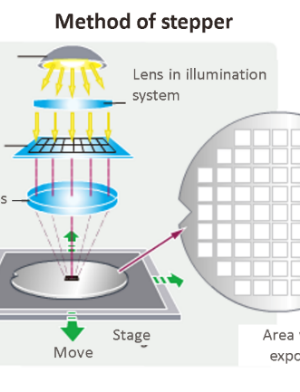
¥1,500.00
技术指标 晶圆尺寸: 6英寸 曝光强度: 600mw/cm² 分辨率: 0.6μm 套刻精度: ±0.08μm…
-

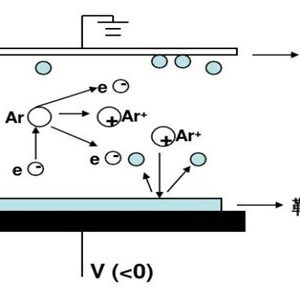
¥1,500.00
技术指标 晶圆尺寸: 6英寸 薄膜种类:氮化铝AlN 片内均一性(1 sigma):≤0.5% Wafer t…
-


¥1,500.00
技术指标 适用于LGA1109/1411/1511/1612/1814等各类芯片尺寸的测试分选 UPH>30k…
-


¥1,500.00
技术指标 晶圆尺寸: 2, 4, 6英寸晶圆及碎片 RCA清洗:DHF+SPM+SC1+SC2 湿法去胶:NM…
-
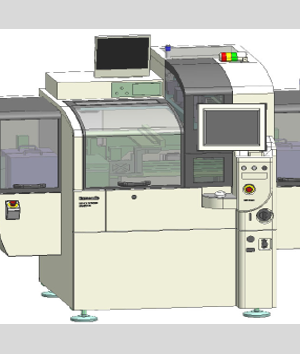
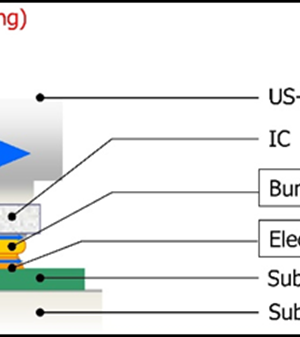
¥1,500.00
技术指标 晶圆尺寸: 2, 4, 6, 8英寸晶圆 精度位置: XY = ± 0.007 mm (3σ) 角度…
-

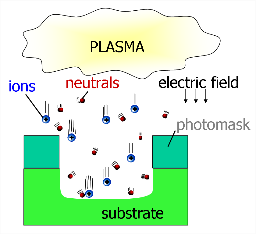
¥1,500.00
技术指标 晶圆尺寸: 6英寸 可刻蚀材料:Si、SiO2、Si3N4等 片内均一性:≤5% 刻蚀速率:>350…
-


¥1,500.00
技术指标 晶圆尺寸: 4, 6英寸 可刻蚀材料: SiO2、Si3N4、AlN、AlScN、LiTaO3、Li…
-


¥1,500.00
技术指标 晶圆尺寸: 6英寸 薄膜种类:Mo 片内均一性(1 sigma):≤0.8% Wafer to Wa…
-

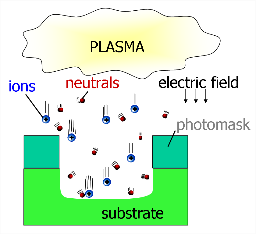
¥1,500.00
技术指标 晶圆尺寸: 6英寸 可刻蚀材料:Al、W、Mo等 片内均一性:≤5% 刻蚀速率:>3500A/min